Аннотация
Для измерения ВАХ (вольт-амперной характеристики) транзистора с высокой подвижностью электронов на основе нитрида галлия (GaN HEMT) требуется особая последовательность включения питания, чтобы избежать повреждения устройства во время испытаний. Инструменты, применяемые для измерения ВАХ, должны поддерживать специальную последовательность включения питания. Программное обеспечение Keithley Automated Characterization Software (ACS) обеспечивает выполнение этой последовательности при измерении характеристик GaN HEMT, что позволяет избежать повреждений устройства и получить его истинные электрические характеристики.
Устройства на основе нитрида галлия
Нитрид галлия (GaN) выделяется благодаря широкозонному запрещённому энергетическому промежутку (шириной около 3,4 эВ), что примерно в три раза больше, чем у кремния. Это свойство используется в ряде инновационных устройств. Например, в оптоэлектронике материалы на основе GaN позволяют получить излучение с более короткой длиной волны, что позволило внедрить на рынок синие и белые светодиоды (LED), а также расширить диапазон длин волн лазерных диодов (LD) до зелёного, синего и ультрафиолетового (UV) спектров. В силовой электронике GaN, как и карбид кремния (SiC), используется для реализации устройств с высоким напряжением изоляции. Ведутся активные разработки вертикальных силовых устройств на GaN с объемной структурой [4].
Кроме того, GaN обладает выдающимися возможностями в области высокоскоростной передачи сигналов. Являясь полупроводником группы III-V, он стоит в одном ряду с такими материалами, как арсенид галлия (GaAs) и фосфид индия (InP), применяемыми в высокочастотной технике — усилителях передачи и малошумящих усилителях приёмников. Среди материалов III-V группы GaN демонстрирует превосходные характеристики по передаваемой мощности и частоте благодаря широкому запрещённому промежутку и высокой насыщенной скорости электронов. Дополнительно он потребляет меньше энергии, что позволяет экономить мощность и уменьшать размеры схем. Эти особенности делают его актуальным в телекоммуникационной инфраструктуре: широкополосной связи, спутниковом вещании, аэрокосмических и оборонных системах. Типичный пример — передатчики базовых станций (BTS), начиная с сетей четвёртого (4G), пятого поколения (5G) и выше [3].
Первый HEMT
В 1980 году был представлен новый тип транзистора — транзистор с высокой подвижностью электронов (HEMT) [1][2]. Первая реализация HEMT включала несколько слоёв GaAs и легированного AlGaAs. Гетеропереход и n-легированный слой AlGaAs приводили к накоплению электронов в слое GaAs, образуя двумерный электронный газ (2DEG). Этот 2DEG обладает более высокой подвижностью по сравнению с традиционными устройствами на GaAs, что способствует высокоскоростной работе. В HEMT 2DEG используется как канал, управляемый через затвор.
GaN HEMT
GaN HEMT — это транзистор из того же семейства, что и GaAs HEMT. В конструкции GaN HEMT используются разнородные кристаллы GaN и AlGaN. Такая структура вызывает образование плотного двумерного электронного газа (2DEG) за счёт пьезоэлектрической и спонтанной поляризации.
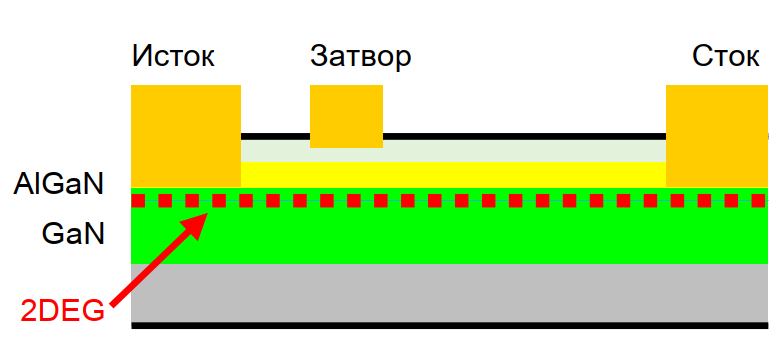
Рисунок 1. Структура GaN HEMT и 2DEG.
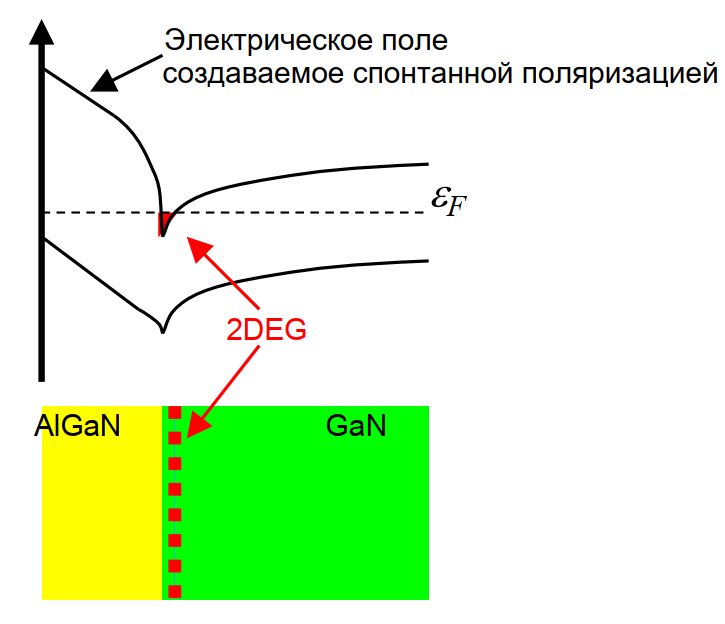
Рисунок 2. Энергетическая диаграмма GaN HEMT, демонстрирующая электрическое поле, создаваемое спонтанной поляризацией.
Как и в других HEMT, управление 2DEG осуществляется через затвор. По умолчанию GaN HEMT — это транзистор с нормально-открытым состоянием («normally-on»), т.е. сток и исток соединены, если не приложено управляющее напряжение на затвор. Чтобы отключить канал, необходимо подать отрицательное напряжение на затвор. В современных разработках стремятся к реализации транзисторов с нормально-закрытым состоянием («normally-off») для повышения безопасности в силовых приложениях [5][6], однако GaN HEMT всё ещё часто используется в связных усилителях в варианте «normally-on».
Последовательность включения питания при измерении ВАХ GaN HEMT
Из-за характера «normally-on» для GaN HEMT требуется специальная последовательность подачи напряжений. В первую очередь инженеры должны подать напряжение на затвор, а уже потом на сток. Отрицательное напряжение на затворе отключает канал между стоком и истоком, что позволяет безопасно подать напряжение на сток. В противном случае возможно появление импульса тока, который может необратимо повредить транзистор. В конце измерений требуется соблюдать обратный порядок.
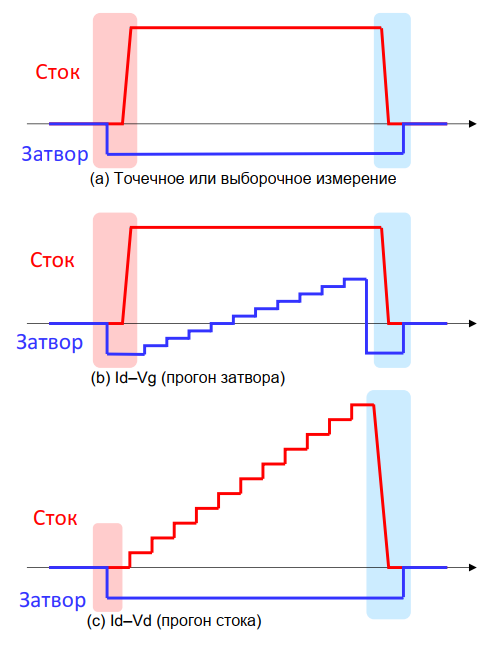
Рисунок 3. Последовательность мягкого смещения GaN HEMT
Программное обеспечение для измерений ВАХ GaN HEMT
Automation Characterization Suite (ACS) от Keithley позволяет конфигурировать отдельные измерительные модули (SourceMeter® SMU) для параметрического анализа, тестирования в производстве и испытаний на надёжность. Используя мощные SMU, ACS может выполнять анализ мощных полупроводников (в том числе LDMOS, IGBT, SiC MOSFET и GaN).
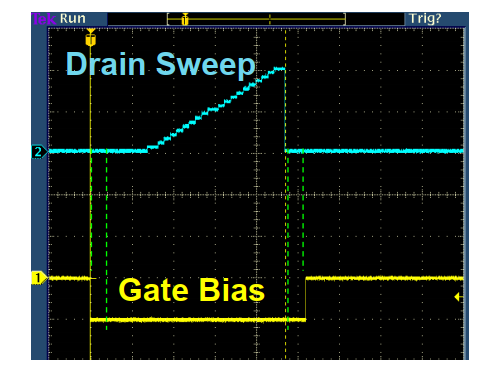
Рисунок 4. Пример последовательности включения питания с использованием ACS.

Рисунок 5. Настройки ACS для последовательности включения питания.
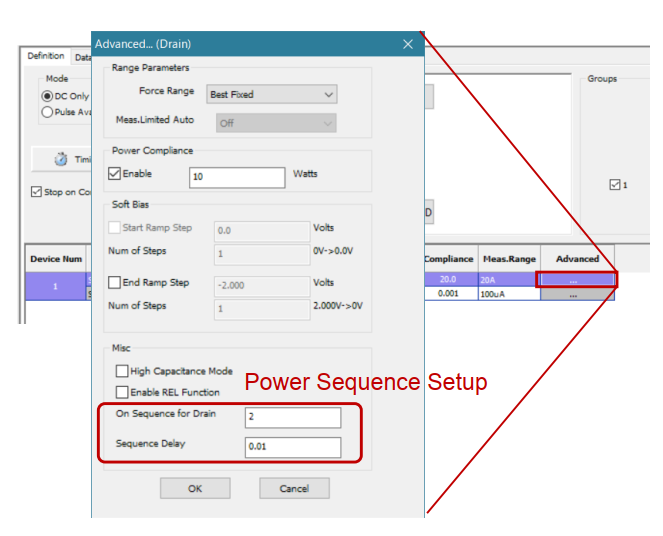
Рисунок 6. Окно настройки последовательности питания.
Мягкое смещение (Soft Bias)
Обычно напряжение прикладывается резко («жесткое смещение» — hard bias), но в ACS реализована функция мягкого смещения — напряжение/ток увеличиваются постепенно, а затем также плавно спадают перед выключением.
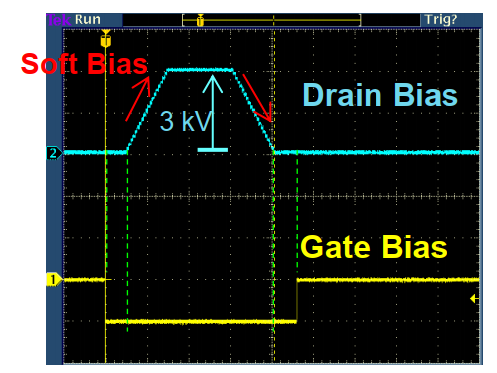
Рисунок 7. Пример мягкого смещения при точечном измерении (до 3 кВ).

Рисунок 8. Окно настройки параметров мягкого смещения (шаг и задержка).
Заключение
GaN HEMT по своей природе — транзистор с нормально открытым состоянием. Для безопасного измерения ВАХ требуется специальная последовательность включения. Программное обеспечение ACS от Keithley обеспечивает её реализацию по умолчанию, а также поддерживает режим мягкого смещения. Эти функции защищают устройство от повреждений и позволяют получить достоверные характеристики.
Список литературы
- Mimura, S. et al. A New Field-Effect Transistor..., Japanese Journal of Applied Physics, 1980.
- Mimura. Invention of HEMT..., Fujitsu Scientific and Technical Journal, 2018.
- Joshin et al. Outlook for GaN HEMT Technology, 2014.
- Toyoda Gosei Co. Vertical GaN Power Device..., 2019. Ссылка
- Tamura. GaN-Based Power Devices..., Panasonic Technical Journal, 2012.
- Umemoto et al. Gate Injection Transistor..., IEEE, 2007.
Перевод выполнен с оригинального документа компании Tektronix: “Power Sequencing for GaN HEMT Characterization – Application Note” (010820).



